CMCリサーチ
★半導体後工程の基礎から最新チップレット技術までを網羅。不具合事例や解析手法も解説し、研究開発・実装現場に直結する実践的知識を凝縮!

2.5D/3Dパッケージングやチップレット技術の最前線を詳説。RoHS・PFAS対応も含め、業界の課題解決に必携の実務書。
📘 書籍概要
タイトル:半導体パッケージングと実装技術のすべて ~ 基礎から最先端まで学ぶ 半導体後工程とチップレット技術 ~(Comprehensive Guide to Semiconductor Packaging and Assembly~ From Basics to Advanced Chiplet Technologies ~)
著者:蛭牟田 要介
発行日:2025年9月10日
体裁:A4判・並製・112頁
定価:70,000 円(税込 77,000 円)
セット価格(書籍+CD):120,000 円(税込 132,000 円)
ISBN:978-4-910581-68-2
編集発行:(株)シーエムシー・リサーチ
📝 本書の特徴
・半導体パッケージングの基礎から応用までを丁寧に解説!
・注目の2.5D/3Dパッケージングとチップレット技術についても詳説!
・著者が長年現場で培ってきた貴重な実践的知識を紹介!
・具体的な不具合の事例や、試作・開発時の評価・解析手法も解説!
・環境規制に対応したRoHSやPFASへの取り組みは?
・半導体パッケージングの未来を見据える一冊!
◎刊行に当たって
半導体は、現代社会において、もはや単なる電子部品ではない。スマートフォン、AI、IoT機器、そして自動車に至るまで、私たちの生活のあらゆる場面でその存在感は増しており、今や経済安全保障の鍵を握る基幹部品へと進化を遂げている。その一方で、半導体製造の先端プロセスは微細化の限界に挑み、2nmという新たな次元に突入しているが、その最先端技術を必要としない半導体が大半を占めるのもまた事実である。しかし、デバイスのさらなる高性能化は、複数のチップを統合する「チップレット」技術へと、業界全体を牽引している。このような時代の潮流の中、本書は半導体製造の「後工程」、すなわち半導体パッケージングに焦点を当て、その基礎から応用までを丁寧に解説するものである。かつて、半導体パッケージはチップを保護し、外部と接続するための単なる「入れ物」に過ぎなかった。しかし、時代の要請に応える形で、多ピン化、高機能化、小型化の道を歩み、DIPからQFP、そしてBGAへと進化を遂げ、今や多種多様なパッケージが誕生している。本書では、こうしたパッケージングの進化・発展の歴史を紐解きながら、各製造プロセスの技術とそのキーポイントを深く掘り下げていく。
本書の特徴のひとつは、著者が長年にわたり半導体製造の現場で培ってきた貴重な経験と知見を余すところなく紹介している点にある。開発当時の苦労話や失敗例、そこから得られた教訓は、理論だけでは得られない実践的な知識として、非常に参考になるのではないだろうか。チップクラック、ワイヤー断線、ポップコーンクラックといった具体的な不具合の事例や、試作・開発時の評価・解析手法についても解説しており、半導体業界に携わる技術者や研究者にとって有用な情報となるであろう。
さらに、最新の技術トレンドを網羅的に理解できるよう、環境規制に対応したRoHSやPFASへの取り組み、そして今後の半導体パッケージングの方向性を左右するであろう2.5D/3Dパッケージング、そしてチップレット技術についても章を割いて解説している。
半導体産業に関わる若手技術者、これからこの分野を目指す学生、そして半導体パッケージングの知識を体系的に学びたいと考えているすべての方々にとって、本書が羅針盤となり、知識を深め、未来を切り開く一助となれば幸いである。
蛭牟田 要介
👥 著者
蛭牟田 要介
蛭牟田技術士事務所
品質・技術コンサルタント 技術士(機械部門/加工・生産システム・産業機械)
【経 歴】
1984~2003:富士通㈱
2003~2009:Spansion Japan㈱
2009~2022:NVデバイス㈱(旧社名 富士通デバイス㈱)
2022.11~:独立技術士
【実 績】
・ 九州職業能力開発大学校附属 川内職業能力開発短期大学校(非常勤講師)
・ 鹿児島大学 理工学研究科 機械工学 片野田研究室主催 鹿児島ハイブリッドロケット研究会(Team KROX)ロケット開発プロジェクト:参画中
・ 半導体後工程関連スポットコンサルテーション:多数
・ 製造品質改善、信頼性向上:コンサルテーション:多数
・ 産業用途向シリコンウェア等の加工プロジェクト:参画中
【専門分野】
半導体後工程・実装、品質・信頼性分野
【研究歴】
・ スーパーコンピュータ向け等ハイエンドのパッケージング技術開発
・ メモリ/ロジックデバイスのLFパッケージング技術全域
・ モバイル向けMCPパッケージング開発と実装接続信頼性向上
・ 特殊用途向けセンサーデバイス、SiP(システムインパッケージ)開発
など
【所属学会】
日本技術士会、エレクトロニクス実装学会
📖 本書の校正・目次概要
第Ⅰ編 半導体製造における後工程・実装・設計の基礎
1.初めに
2.半導体パッケージの基礎 ~パッケージの進化・発展経緯~
2.1 始まりはSIPとDIP、プリント基板の技術進化に伴いパッケージ形態が多様化
2.1.1 パッケージ進化の歴史
2.1.1.1 初期の発展
2.1.1.2 技術の進化
2.1.1.3 現代のトレンド
2.1.1.4 未来の展望
2.1.2 単位系の話
2.2 THD(スルーホールデバイス)とSMD(表面実装デバイス)
2.2.1 様々なパッケージ
2.2.2 THD(スルーホールデバイス)
2.2.2.1 SIP (Single Inline Package)とDIP (Dual Inline package)
2.2.2.2 PGA (Pin Grid Array)とLGA (Land Grid Array)
2.2.3 SMD(表面実装デバイス)
2.2.3.1 SOJ (Small Outline J-leaded package)
2.2.3.2 SON (Small Outline Non-leaded)とQFN(Quad Flat Non-leaded)
2.2.3.3 SOP (Small Outline Package)
2.2.3.4 TSOP (Thin Small Outline Package)
2.2.3.5 QFJ (Quad Flat J-leaded)
2.2.3.6 QFP (Quad Flat Package)
2.2.3.7 BGA (Ball Grid Array)
2.2.3.8 WLP (Wafer Level Package)
2.2.3.9 TCP (Tape Carrier Package)
2.2.4 一瞬だったパッケージ(代表的なパッケージ)
2.2.4.1 QIP (Quad Inline Package)
2.2.4.2 LCC (Leadless Chip Carrier)
2.2.4.3 SVP (Small Vertical Package または Surface Vertical Package)
2.2.4.4 BCC (Bump Chip Carrier)
2.2.4.5 CSOP (C-leaded Small Outline Package)
2.3 セラミックスパッケージとプラスチック(リードフレーム)パッケージとプリント基板パッケージ
2.3.1 セラミックスパッケージ
2.3.2 リードフレームパッケージ
2.3.2.1 代表的なリードフレーム製造方法
2.3.2.2 スタンピング(プレス)
2.3.2.3 エッチング
2.3.3 プリント基板パッケージ
3.パッケージングプロセス(代表例)
3.1 セラミックスパッケージのパッケージングプロセス
3.2 プラスチック(リードフレーム)パッケージのパッケージングプロセス
3.3 プリント基板パッケージのパッケージングプロセス
4.各製造工程(プロセス)の技術とキーポイント
4.1 パッケージング前工程
4.1.1 BG(バックグラインド工程)とダイシング工程
4.1.2 DB(ダイボンド)
4.1.2.1 AuSi共晶接合
4.1.2.2 接着剤(Agペースト)
4.1.2.3 DAF (Die Attach Film)
4.1.3 WB(ワイヤーボンド)
4.1.3.1 ウェッジボンディング
4.1.3.2 ボールボンディング
4.1.3.3 ワイヤー材質
4.2 封止・モールド工程
4.2.1 シームウェルド(封止:セラミックパッケージ)
4.2.2 モールド封止
4.2.2.1 トランスファーモールディング
4.2.2.2 マルチプランジャーモールディング
4.2.2.3 コンプレッションモールディング
4.3 組立後工程
4.3.1 外装メッキ
4.3.1.1 Snメッキ、Sn-Biメッキ
4.3.2 切断・整形
4.3.3 ボール付け
4.3.4 シンギュレーション
4.3.5 捺印
4.4 バンプ・FC(フリップチップ)パッケージの組立工程
4.4.1 再配線・ウェーハバンプ
4.4.2 FC(フリップチップ)
4.4.2.1 C4(Controlled Collapse Chip Connectionの略)
4.4.2.2 C2(Chip Connectionの略)
4.4.2.3 ACP/ACF
4.4.2.4 NCP/NCF
4.4.3 UF(アンダーフィル)
4.5 テープキャリアパッケージ(TCP)の組立工程
4.5.1 Bump(メッキバンプ)
4.5.2 インナーリードボンディング(ILB)
5.試験工程とそのキーポイント
5.1 代表的な試験工程
5.2 BI(バーンイン)工程
5.3 外観検査(リードスキャン)工程
5.4 梱包工程とそのキーポイント
5.4.1 ベーキングと吸湿管理
5.4.2 トレイ梱包
5.4.3 テーピング梱包
6.過去に経験した組立・実装関連不具合の一例
6.1 チップクラック
6.2 ワイヤー断線
6.3 パッケージが膨れる・割れる
6.3.1 ポップコーンクラック
6.3.2 表面膨れ・剥離
6.4 実装後、パッケージが基板から剥がれる
6.5 BGAのボールが取れる(落ちる・破断する)
6.6 パッケージが燃える(焦げる)
7.試作・開発時の評価、解析手法の例
7.1 破壊試験と強度確認
7.2 MSL(吸湿・リフロー試験)
7.3 機械的試験と温度サイクル試験
7.4 SAT(超音波探傷)、XRAY(CT)、シャドウモアレ
7.5 開封、研磨、そして観察
7.6 ガイドラインはJEITAとJEDEC
8.RoHS、グリーン対応
8.1 鉛フリー対応
8.2 樹脂の難燃剤改良
8.3 PFAS/PFOS/PFOAフリー
9.今後の2.5D/3Dパッケージとチップレット技術
9.1 先端パッケージ戦略
9.2 チップレット技術
9.2.1 CoWoS®️
9.2.2 裏面電源供給
9.3 ハイブリッドボンディング
9.4 製造のキーはチップとインターポーザー間接合とTSV
9.4.1 3Dパッケージングの課題
9.4.2 チップ間の接合方法
9.4.3 インターポーザーの材料
9.4.4 積み上げたチップの信頼性の保証は誰が担う?
9.5 光チップレット実装技術(光電融合デバイス)
9.6 チップレットのデザインルール
9.7 基板とインターポーザーの進化が未来を決める
9.7.1 ガラスコア基板
10.終わりに
参照・引用文献一覧
第Ⅱ編 チップレット技術による既存チップの統合 :メリット、デメリット、技術的課題
1.メリット
1.1 開発期間とコストの削減
1.1.1 設計期間の短縮
1.1.2 開発費の抑制
1.1.3 多品種少量生産への対応
1.1.4 リスクの低減と歩留まり向上
1.1.5 異種統合と最適なプロセスノードの選択
1.1.6 異なる半導体材料の統合
1.1.7 部品調達の柔軟性
2.デメリット
2.1 パッケージングコストの増加
2.2 性能および電力効率の課題
2.2.1 インターコネクトによる性能劣化
2.2.2 電力効率の低下
2.2.3 熱管理の複雑化
2.2.4 サプライチェーンの複雑化と管理の課題
2.2.5 インターオペラビリティの確保
2.2.6 設計・検証の新たな課題
2.2.7 品質保証
2.3 技術的課題
2.3.1 インターコネクト技術の高度化
2.3.2 高密度接続技術
2.3.3 熱管理技術の進化向上
2.3.4 熱応力緩和
2.3.5 パッケージング技術の精密化と歩留まり向上
2.3.6 テスト・検証手法・トレーサビリティの確立
2.4 設計エコシステムの整備
2.4.1 チップレットライブラリと設計ツール
3.結論
参考文献
第Ⅲ編 半導体後工程でのPFASについて
1.半導体産業への影響と代替材料の開発
2.半導体後工程に関して
3.もし、抵触するとした場合の規制
3.1 EU REACH規則(化学物質の登録、評価、認可、制限に関する規則)
3.2 EU POPs規則 (残留性有機汚染物質に関する規則)
3.3 日本の化審法(化学物質の審査及び製造等の規制に関する法律)
3.4 その他の各国の規制
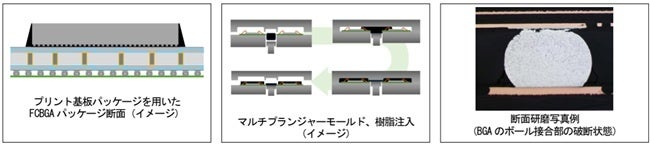
※詳細目次は下記リンクからご覧いただけます。
先端技術情報や市場情報を提供している(株)シーエムシー・リサーチ(千代田区神田錦町: https://cmcre.com/ )では、 各種材料・化学品などの市場動向・技術動向のセミナーや書籍発行を行っております。
📂 関連情報
①関連書籍
「世界のチップレット・先端パッケージ 最新業界レポート Chiplet・Advanced Packaging」
■ 発 行:2024年11月13日
■ 定 価:本体(冊子版)140,000円(税込 154,000円)
本体 + CD(PDF版)190,000円(税込 209,000円)
★ メルマガ会員:定価の10%引き!
■ 体 裁:A4判・並製・200頁
■ 編集発行:㈱シーエムシー・リサーチ
ISBN 978-4-910581-60-6
②開催予定ウェビナー
○ゼロカーボン時代のプラスチックのリサイクル
2025年9月16日(火)13:30~16:30
https://cmcre.com/archives/135304/
※見逃し配信付
○2時間で理解するAI創薬入門
2025年9月17日(水)10:00~12:00
https://cmcre.com/archives/131990/
○Microphysiological Systems(MPS)の基礎と応用、開発動向
2025年9月18日(木)13:30~16:30
https://cmcre.com/archives/132889/
○光無線給電技術の基礎,技術動向,展望
2025年9月19日(金)10:30~16:30
https://cmcre.com/archives/130998/
○AIデータセンタ用放熱/冷却技術
2025年9月24日(水)10:30~16:30
https://cmcre.com/archives/134967/
○FPD用ガラスと半導体パッケージ用ガラスに対する技術及び開発動向並びにガラスの加工と強度・強化方法
2025年9月25日(木)13:30~16:30
https://cmcre.com/archives/135357/
○次世代パワー半導体とパワーデバイスの結晶欠陥評価技術とその動向
2025年9月29日(月)13:30~16:30
https://cmcre.com/archives/135061/
※見逃し配信付
○金属材料の腐食の基礎とメカニズムおよび腐食対策と防食技術のポイント
2025年10月1日(水)10:30~16:30
https://cmcre.com/archives/135908/
※見逃し配信付
○シリカ微粒子の用途および先端分野における役割と活用例~ 日常製品から先端製品で使われるシリカ微粒子 ~
2025年10月7日(火)13:30~16:30
https://cmcre.com/archives/135374/
○レアメタルの概要と注目市場 ― 車載LIB、電動化、半導体、電子・電池材料、航空機・軽金属用途の原料市場
2025年10月9日(木)13:30~16:30
https://cmcre.com/archives/133844/
○スラリー調製及び評価の基礎~ セラミックススラリーから電池電極スラリーまで ~
2025年10月10日(金)10:30~16:30
https://cmcre.com/archives/135869/
※見逃し配信付
○経口投与可能な核酸を使った肝線維化治療方法の開発
2025年10月10日(金)13:30~16:30
https://cmcre.com/archives/135198/
○微生物動態をリアルタイムに可視化! 熱測定で叶える新しい活性評価と抗菌評価
2025年10月14日(火)13:30~16:30
https://cmcre.com/archives/134999/
○5G/6Gに対応するフレキシブル基材とFPC形成技術 ~ LCP-FCCLとその発展 ~
2025年10月15日(水)13:30~16:30
https://cmcre.com/archives/135923/
※見逃し配信付
○半導体パッケージ技術の基礎講座
~ パッケージ形態の変遷、製造工程と用いられる装置・材料、最新トレンドまで ~
2025年10月16日(木)13:30~16:30
https://cmcre.com/archives/136032/
以上